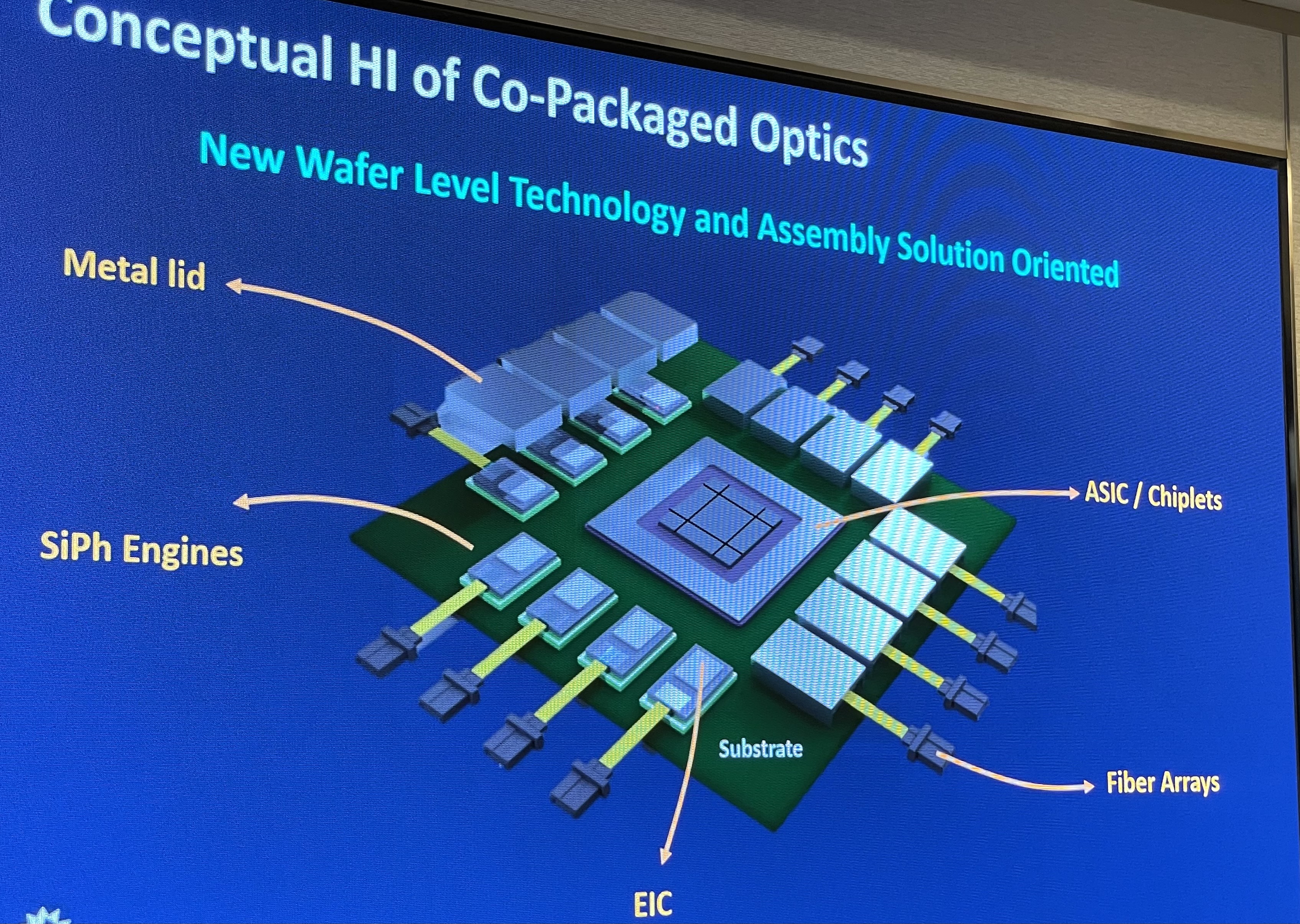 台积电宣布将于2026年量产矽光子(CPO)先进封装。图为日月光展示COP的架构。记者简永祥/摄影
台积电宣布将于2026年量产矽光子(CPO)先进封装。图为日月光展示COP的架构。记者简永祥/摄影
台积电在美西技术论坛中也宣布先进封装技术大跃进,台积电将在核心的CoWoS技术下,持续引导入客户导入系统整合晶片 (SoIC),并于2025年完成矽光子(Co-Packaged Optics, CPO)前期的支援小型插拔式连接器的COUPE验证,再搭配CoWoS封装成为共同封装光学元件(Co-Packaged Optics, CPO),将光连结直接导入封装中,完成AI先进封装的革命性关键技术。
台积电强调,台积电的CoWoS,是让客户能够在单一中介层上并排放置更多的处理器核心及高频宽记忆体(HBM)。同时,台积公司的系统整合晶片 (SoIC)已成为3D晶片堆叠的领先解决方案,客户越来越趋向采用CoWoS搭配SoIC及其他元件的做法 ,以实现最终的系统级封装(Systemin Package, SiP)整合。
/*.innity-apps-underlay-ad {z-index: 34 !important; }*/ .innity-apps-underlay-ad ~ .header {z-index: 35;} .innity-apps-underlay-ad ~ .main-content .inline-ads { background: transparent;} #eyeDiv ~ .footer{ position: relative; z-index: 2;} /* sizmek_underlay 投递调整置底 z-index 权重 */ .article-content__abbr__text {display:inline-block;} /* to be remove */
台积电强调,公司系统级晶圆(TSMC-SoW)技术提供了一个革新的选项,让12吋晶圆能够容纳大量的晶粒,提供更多的运算能力,大幅减少资料中心的使用空间,并将每瓦效能提升好几个数量级。台积电已经量产的首款SoW产品采用以逻辑晶片为主的整合型扇出(InFO)技术,而采用CoWoS技术的晶片堆叠版本预计于2027年准备就绪,能够整合SoIC、HBM及其他元件,打造一个强大且运算能力媲美资料中心伺服器机架或甚至整台伺服器的晶圆级系统。
其中在矽光子整合更获得重大突破,台积电表示,公司正在研发紧凑型通用光子引擎(COUPE)技术,以支援AI热潮带来的数据传输爆炸性成长。 COUPE使用SoIC-X晶片堆叠技术将电子裸晶堆叠在光子裸晶之上,相较于传统的堆叠方式,能够为裸晶对裸晶介面提供最低的电阻及更高的能源效率。
台积电预计于2025年完成支援小型插拔式连接器的COUPE验证,接著于2026年整合CoWoS封装成为共同封装光学元件(Co-Packaged Optics, CPO),将光连结直接导入封装中。
台积电也宣布,将继2023年推出支援车用客户及早采用的N3AE制程后, 借由整合先进晶片与封装来持续满足车用客户对更高运算能力的需求,以符合行车的安全与品质要求。台积电正在研发InFO-oS及CoWoS-R解决方案,支援先进驾驶辅助系统(ADAS)、车辆控制及中控电脑等应用,预计于2025年第4季完成AEC-Q100第二级验证。